Spektrometria mas jonów wtórnych z analizatorem czasu przelotu (TOF-SIMS)
Spektrometria mas jonów wtórnych z analizatorem czasu przelotu, w skrócie TOF-SIMS, jest metodą analityczną czułą na powierzchnię. Analizowana próbka jest skanowana zogniskowaną wiązką jonów, dzięki czemu cząsteczki są uwalniane z górnej warstwy materiału - w tym jony wtórne, które są wykorzystywane w TOF-SIMS do celów analizy. Samo wykrywanie odbywa się za pomocą detektora czasu przelotu, który może rejestrować pełne widmo masowe podczas jednego impulsu rozpylania.
W ten sposób bada się powierzchnie ciał stałych pod kątem ich właściwości chemicznych. Tutaj skład powierzchni próbki jest analizowany na poziomie elementarnym i molekularnym. Metoda ta daje również możliwość pełnej trójwymiarowej analizy próbki. W przypadku TOF-SIMS jako materiał próbki nadaje się duża liczba substancji, takich jak półprzewodniki, polimery, papier, szkło, ceramika i wiele innych.
Jak działa system TOF-SIMS
Na badanej próbce skupiana jest impulsowa wiązka pierwotna o energii do 30 keV. Zderzenia (kaskada kolizji) zachodzą między jonami wiązki pierwotnej a materiałem próbki (najwyższa monowarstwa), w której uwalniane są głównie cząstki neutralne, ale także cząstki pozytywnie i negatywnie naładowane. Te naładowane cząstki są następnie przyspieszane w polu elektrycznym w kierunku spektrometru mas.
-
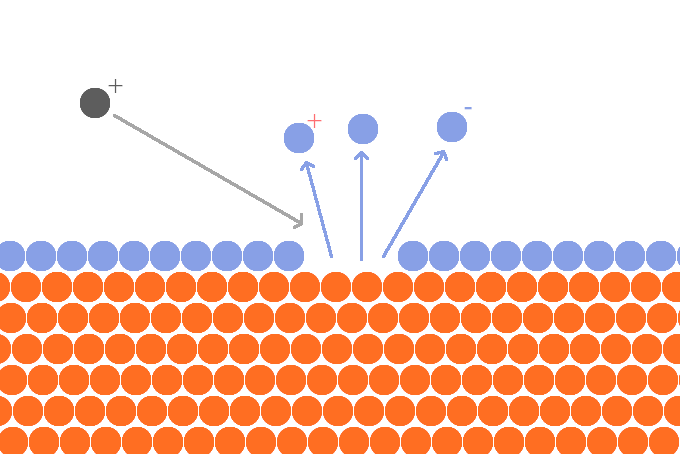
Schematyczny widok interakcji jonów pierwotnych z monowarstwą próbki w TOF-SIMS
Podczas analizy naładowanych cząstek TOF-SIMS wykorzystuje fakt, że jony o tej samej energii, ale różnych masach poruszają się z różnymi prędkościami. Jony lżejsze mają większe prędkości i docierają do detektora szybciej niż jony cięższe. Pomiar czasu lotu cząstki umożliwia wyznaczenie jej masy.
Podstawowa budowa spektrometru mas jonów wtórnych z analizatorem czasu przelotu
System TOF-SIMS składa się zasadniczo z komponentów
- Kolumna z wiązką jonów z impulsowo działającą wiązką pierwotną jonów
- Stolik na próbki
- Electron Flood Gun do kompensacji ładunku
- Spektrometr mas z analizatorem czasu przelotu (analizator TOF)
-
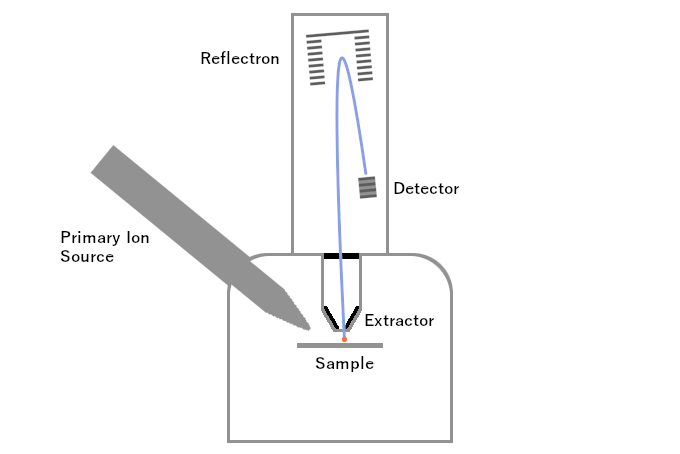
Podstawowa budowa TOF-SIMS: kolumna wiązki jonów pierwotnych, próbka, ekstraktor, reflektron, detektor
Kolumna z wiązką jonów z impulsowo działającą wiązką pierwotną jonów
Kolumna wiązki jonów zasadniczo składa się z czterech sekcji, które można logicznie podzielić na działo jonów, elektrostatyczne kształtowanie wiązki, pulsowanie wiązki i końcowe kształtowanie wiązki (zogniskowanie na próbce).
Działo jonów może składać się ze działa jonów ciekłego metalu (LMIS). W zależności od producenta stosowane są różne materiały, takie jak działo bizmutowe (Bi). Wykorzystywane są również źródła jonów klastrów gazowych z argonem.
Wiązka jest kształtowana przez apertury, elektrostatyczne soczewki Einzela i kwadrupole. Pulsowanie pierwotnej wiązki jonów jest osiągane przez elektrostatyczny blanker. Ostateczne kształtowanie wiązki, które skupia wiązkę jonów na próbce, uzyskuje się z kolei za pomocą specjalnej soczewki Einzela oraz kwadrupoli i oktupoli. Tutaj obowiązuje zasada: im mniejsza średnica wiązki, tym lepsza rozdzielczość przestrzenna.
Stolik na próbki do TOF-SIMS
Stolik na próbki do aplikacji TOF-SIMS można zwykle przesuwać w pięciu osiach X, Y, Z, a także R (rotacja) i T (pochylenie). Stolik na próbki znajduje się na potencjale uziemienia systemu.
Electron Flood Gun do kompensacji ładunku
W przypadku materiału nieprzewodzącego, rozpylanie jonowe na powierzchni próbki może prowadzić do problemu, że uziemienie stolika na próbki nie może być wykorzystane do kompensacji ładunku. Gdy materiał jest bombardowany przez jony, na próbkę wprowadza się więcej naładowanych cząstek niż się rozpyla (usuwa). Może to prowadzić do narastania potencjału. Ładunek ten zakłóca proces i dlatego konieczne jest rozproszenie potencjału za pomocą działa elektronowego, tak zwany Electron Flood Gun.
Electron Flood Gun wkracza do akcji po każdym cyklu, który obejmuje impuls wiązki jonów pierwotnych i późniejszą ekstrakcję jonów wtórnych. W ten sposób naładowania mogą zostać kompensowane. Negatywne skutki nadmiaru elektronów są neutralizowane za pomocą tzw. napięcia Extraction Bias.
Spektrometr mas z analizatorem czasu przelotu (analizator TOF)
Właściwy spektrometr TOF-SIMS składa się z ekstraktora, który przyspiesza jony wtórne z próbki w kierunku detektora. W idealnym przypadku jony wtórne mają taką samą energię kinetyczną, gdy przechodzą przez przestrzeń wolną od pola. Analiza opiera się na różnicy w stosunku masy do ładunku (stosunek m/z). Intensywność wykrytego sygnału jako funkcja czasu lotu pomaga stwierdzić proporcje nuklidów lub izotopów w próbce (pod warunkiem, że detektor jest skalibrowany).
Ponieważ w rzeczywistych warunkach nie jest możliwe, aby wszystkie jony wtórne miały dokładnie taką samą energię, to w TOF-SIMS stosuje się przykładowo reflektron. Reflektron jest zwierciadłem elektrostatycznym, do którego wnikają jony, które są następnie odbijane do detektora. Jony wtórne o wyższej energii mają dłuższą trajektorię, ponieważ wnikają głębiej do zwierciadła. Jony o niższej energii odbijają się szybciej i mają krótszą trajektorię do detektora TOF-SIMS. Dzięki temu urządzeniu wszystkie jony o tej samej masie docierają do detektora w tym samym czasie.
-

Schematyczny przykład reflektronu TOF-SIMS
Tryby pracy TOF-SIMS
Spektrometry masowe jonów wtórnych z analizatorem czasu przelotu mogą być stosowane w różnych trybach pracy. Poniżej opisano cztery najpopularniejsze tryby.
Spektrometria powierzchni
Celem spektrometrii powierzchni jest zwykle badanie pierwotnego składu powierzchni. Ponieważ SIMS jest zwykle metodą destrukcyjną, do celów analizy należy stosować niską dawkę jonów pierwotnych.
W tym celu TOF-SIMS działa jako statyczny SIMS, co oznacza, że dotykane są tylko górne monowarstwy próbki i unika się poważnego zniszczenia. Osiągane prądy jonowe są niskie, ale można uzyskać szczegółowe informacje elementarne i molekularne. Ta metoda ma czułość w zakresie ppm/ppb.
Obrazowanie/mapowanie powierzchni
W przypadku obrazowaniu powierzchni badana powierzchnia próbki jest skanowana za pomocą precyzyjnie skupionej wiązki jonów. Podobnie jak w mikroskopie elektronowym, można uzyskać obraz, który dostarcza informacji o rozkładzie masy jonów wtórnych i jest odpowiedni do mapowania chemicznego powierzchni.
Profilowanie głębokości
Podczas analizy profili głębokości TOF-SIMS działa w trybie podwójnej wiązki. Jedna wiązka jonów jest używana do analizy powierzchni, a druga wiązka jonów jest wykorzystywana do rozpylania krateru.
Rozpylanie jonowe odbywa się za pomocą reaktywnej wiązki jonów składającej się na przykład z tlenu (O2) lub cezu (Cs). Możliwe jest również wykorzystanie klastrów. Energia tych wiązek jonów jest niska, aby osiągnąć wyższą czułość i wysoką rozdzielczość głębi.
Analiza 3D
Analiza 3D z wykorzystaniem TOF-SIMS to połączenie trybów pracy spektrometrii, obrazowania i profilowania głębokości. Za pomocą tego badania można analizować złożone i nieznane struktury oraz defekty.
Możliwe próbki materiałów do analizy w TOF-SIMS
Spektrometr mas jonów wtórnych z detektorem czasu przelotu pozwala na badanie dużej liczby różnych materiałów. Mogą one być zarówno elektrycznie przewodzące, jak i izolujące i obejmują między innymi biomateriały, szkło, farmaceutyki, powłoki, półprzewodniki i polimery.
Zastosowania spektrometrów TOF-SIMS
Duża liczba materiałów, które można badać, daje również wiele możliwości zastosowania spektrometrów TOF-SIMS.
Wykrywanie metali śladowych
W branży półprzewodników coraz ważniejsze staje się wykrywanie metali śladowych w półprzewodnikach. Szczególnie dobrze nadają się do tego spektrometry TOF-SIMS, ponieważ potrafią również wykrywać lekkie pierwiastki i ich izotopy.
Zanieczyszczenie półprzewodników
Za pomocą spektrometru TOF-SIMS możliwe jest wykrycie zanieczyszczeń nieorganicznych i organicznych w półprzewodnikach. Takie zanieczyszczenie może wystąpić podczas procesu produkcyjnego poprzez kontakt z rękawiczkami lub narzędziami. Zanieczyszczenia w czystym pomieszczeniu mogą również osadzać się na półprzewodnikach. Ostatecznie w wyniku dalszej obróbki chemicznej półprzewodniki mają bezpośredni kontakt z niepożądanymi substancjami w produkcie końcowym.



